Dualbeam Electron Microscope
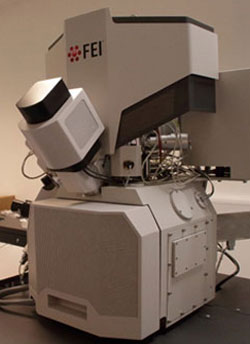
The FEI Scios dualbeam combines a high resolution scanning electron microscope (SEM) with the ability to mill and image a sample using a focused ion beam (FIB). Through concurrent milling of the sample using the FIB and imaging using the SEM it is possible to selectively image sub-surface features, prepare site-specific TEM samples and fabricate of nano-structures.
The FIB is capable of rapidly milling away the sample using high beam currents or using lower beam currents to mill fine features and produce images. The Scios is equiped with a gas injection system allows carbon or platinum to be deposited on the sample to protect surface features during TEM sample preparation or fabricate electrical current pathways. Serial milling with the FIB and imaging with the SEM can be used to produce three-dimensional reconstructions of the sample.
Specifications:
Schottky FEG electron source
SEM voltage: 200V – 30kV
SEM resolution: 1nm
High current Ga liquid metal source
FIB voltage:500V – 30kV
FIB probe current: 1.5 pA – 65 nA
FIB resolution:5nm
EDAX Octane Plus EDS detector
3D reconstruction software
Easylift nano-manipulator
Platinum and carbon deposition
More details are available on the St Andrews Electron Microscope Facility website.
Lab: St Andrews Electron Microscopy Facility
KY16 9ST
Contact: David Miller